第二部 【企業情報】
第1 【企業の概況】
1 【主要な経営指標等の推移】
(1) 連結経営指標等
(注) 1.第2期より国際会計基準(以下、「IFRS」という。)に基づいて連結財務諸表を作成しております。
2.株価収益率は、当社株式が非上場であるため記載しておりません。
3.第2期、第3期及び第4期のIFRSに基づく連結財務諸表については、金融商品取引法第193条の2第1項の規定に基づき、有限責任 あずさ監査法人の監査を受けております。
4.従業員数は出向社員を除き、受入出向社員を含む就業人員数であります。
5.臨時従業員数は、契約社員、パートタイマー及びアルバイトであり、外書きしております。
(2) 提出会社の経営指標等
(注) 1.当社は2021年12月13日設立のため、第1期は2021年12月13日から2022年3月31日までの期間となっております。なお、凸版印刷株式会社(現TOPPANホールディングス株式会社、以下同様であります。)から実質的に事業を承継したのは第2期からであり、第1期における収益及び費用の計上はありません。また、第1期末における人員はおりません。
2.1株当たり配当額及び配当性向については、第3期以外は配当を実施していないため記載しておりません。
3.第1期の潜在株式調整後1株当たり当期純利益については、潜在株式が存在しないため記載しておりません。
4.株価収益率は、当社株式が非上場であるため記載しておりません。
5.第3期及び第4期の財務諸表については、「財務諸表等の用語、様式及び作成方法に関する規則」(昭和38年大蔵省令第59号)に基づき作成しており、金融商品取引法第193条の2第1項の規定に基づき、有限責任 あずさ監査法人の監査を受けております。第1期及び第2期の財務諸表については、会社計算規則(平成18年法務省令第13号)の規定に基づき算出した各数値を記載しており、金融商品取引法第193条の2第1項の規定に基づく監査証明を受けておりません。
6.従業員数は、出向社員を除き、受入出向社員を含む就業人員数であります。
7.臨時従業員数は、契約社員、パートタイマー及びアルバイトであり、外書きしております。
2 【沿革】
当社の前身は、凸版印刷株式会社グループ(以下「TOPPANグループ」という。)のフォトマスク事業及びそれに付随又は関連する事業となります。
2020年代に入り、半導体市場の急速な成長によってフォトマスクの市場は新たな局面を迎え、事業の継続的な拡大・成長のためには、市場環境の変化や顧客動向を見極めながら、これまで以上に迅速かつ柔軟な研究開発投資と設備投資が求められるようになりました。
こうした中、TOPPANグループはフォトマスク事業及びそれに付随又は関連する事業については独立した企業体として経営の自由度を高めることによって、半導体市場のニーズを捉えた投資をスピーディーに実行し、より一層の成長と競争力の強化を実現・継続していくことが、当事業の価値向上に資するとの判断に至りました。
その結果、当社は2021年12月13日に、TOPPANグループのフォトマスク事業及びそれに付随又は関連する事業の承継会社として設立され、2022年4月1日に権利義務を承継する吸収分割に合わせ、独立系投資ファンドであるインテグラル株式会社(以下、同社及び同社が運用アドバイザーを務める投資ファンドを総称して「インテグラルグループ」とする。)を出資パートナーに迎えて事業を開始しております。
(当社設立前)
(当社設立後)
3 【事業の内容】
当社は、半導体用フォトマスクの製造・販売会社として、TOPPANグループから吸収分割により事業を継承する会社として設立され、2022年4月より営業を開始しました。
当社グループは、当社、連結子会社13社及び持分法適用会社2社の計16社で構成されており、世界各地に広がるサービスネットワークと主要な半導体需要地域に所在する8つの製造拠点を活用し、EUVフォトマスク生産などを手掛ける等、業界最先端の技術開発力で、外販フォトマスク市場のリーディングカンパニーとして事業活動を行っております。また、微細加工技術を応用し、ナノインプリントモールド等の新事業領域の開拓を進めております。
当社グループの事業は、前身であるTOPPANグループにおいて印刷テクノロジーの一つである微細加工技術を応用し、1968年にトランジスタ用のマスクの量産を開始したことに端を発しております。以来、半世紀以上に及ぶ歴史の中で、台湾に中華凸版電子股份有限公司(現:中華科盛德光罩股份有限公司)を設立し、またDuPont Photomasks Inc.を買収することで、今日では世界各国に製造拠点を有する外販フォトマスクメーカーとして、2024年において半導体向け外販フォトマスク市場におけるシェア38.9%というトップの位置におります。(出典:SEMI「2024 PHOTOMASK CHARACTERIZATION STUDY」)
当社グループの報告セグメントはフォトマスク事業の単一セグメントでありますが、事業の内容の記載にあたりましては、以下「フォトマスク事業領域」と「新事業領域」に区分して記載いたします。
(フォトマスク事業領域)
フォトマスクとは、フォトリソグラフィ技術※において、対象物に任意の図形(パターン)を転写するための原版となるガラス基板であり、一般に写真のネガに例えられます。
今日では半導体製造工程の一つである露光(リソグラフィ)プロセスにおいて広く使用されており、フォトマスク上の半導体回路パターンをシリコンウェハ上に縮小露光することにより微細な回路パターンを形成することが可能となります。当社グループでは、半導体メーカーや研究機関等の顧客から量産及び試作・研究開発用途で、様々な高精細フォトマスクの製造を受託しております。
半導体用フォトマスクは、半導体製造プロセスにおける「金型」として極めて重要な役割を果たすものであり、微細かつ高精度な製品を短納期で納入することが求められます。
フォトマスクは、顧客より支給された半導体回路のパターンデータをもとに、電子ビーム等でマスクブランクス(ガラス基板上に遮光膜を成膜し、その上に感光材であるフォトレジストをコーティングしたもの)上に回路パターンを描画し、現像・エッチングを経て製造されます。顧客に納入するに際しては、この後、各種寸法の測定や外観形状の検査を経て、顧客が要求する精度・仕様に合致していることの品質保証が必要となります。
a 半導体用フォトマスクについて
(a) 業界構造及び当社グループの事業領域について
半導体市場におけるビジネスモデルは、時代とともに大きく変化しており、かつては設計から製造まで一貫して行う垂直統合型が主流でしたが、1980年代後半以降、微細化競争の激化に伴い、水平分業型が台頭しました。今日の市場は、半導体の設計から製造、販売までを一貫して行う垂直統合型デバイスメーカー「IDM(Integrated Device Manufacturer)」が存続している一方、水平分業型モデルにおける自社で製造工程を持たない「ファブレス」と呼ばれるモデルとして、半導体設計のみを手掛ける「デザインハウス」と、実際にその半導体製造を請け負う「ファウンドリ」と呼ばれるプレイヤーによって構成されております。
IDMがフォトマスクを自社で内作する方針を継続してきた一方、水平分業化の潮流の中で、ファウンドリにおいてはフォトマスクの生産を100%外部委託するモデルも確立されました。これにより、半導体用フォトマスクは内作と外販という2つの大きな市場を形成しております。
当社グループは外販フォトマスクメーカーとして、内作機能を持たないファウンドリからの需要に加え、内作において生産キャパシティを超過した際のフォトマスク需要についても製造を委託されております。半導体デバイス製造工程におけるフォトマスクの位置づけを図に示すと以下のとおりとなります。
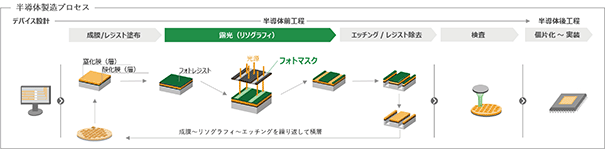
(b) 需要構造について
半導体デバイスは、主にロジック半導体とメモリ半導体に大別されます。
ロジック半導体は、電子機器の頭脳とも呼べるもので、情報を処理し、論理演算や制御を行うものであり、CPU(中央処理装置)やGPU(画像処理装置)等がこれに該当します。汎用的なものから特定のアプリケーションに特化したものまで幅広い製品が存在しますが、基本的にはアプリケーションごとに開発設計がなされます。特に先端品領域では微細化技術の進展に伴う設備投資負担の高まりから、前述の水平分業化が進んでおります。
メモリ半導体は、データを記憶するための半導体であり、短期記憶向けのDRAMや長期記憶向けのNAND型フラッシュメモリ等が該当します。メモリ半導体は主に同一製品を大ロットで量産・在庫販売するものであるため、メモリ半導体メーカーは規模の経済を追求するため垂直統合型が主流となります。そのため、ロジック半導体と比較して、メモリ半導体用フォトマスクはIDMによる内作の割合が高い市場となります。当社グループにおいては、ロジック半導体用フォトマスクが主軸製品となり、メモリ半導体用フォトマスクについては主に内作を持たないメモリサプライヤー向けにDRAM用フォトマスクの製造を請け負っております。
当社グループにおける半導体用フォトマスクの生産量は、フォトマスクが回路原版として使われるため、単に半導体市場全体の製造ボリュームに比例するものではなく、回路パターンの複雑さや半導体デバイスの設計件数に影響を受けます。そのため、同一製品を大量生産するメモリ半導体市場よりもロジック半導体市場の動向に左右されやすい傾向にあるといえます。
また、半導体市場においては微細化の度合いを、回路線幅等に基づくプロセスノード※によって分類し、「〇〇ナノメートル」と表現しております。基準値はその時代々々によって流動的であるものの、プレイヤーの限られる先端技術を用いて作られるものを「先端ノード」、技術的に普及が進んだものを「レガシーノード」と大別されております。かつては微細化が進むことで既存のレガシーノード需要が先端ノードに置き換えられてしまうという、プロセスマイグレーションの考え方が一般的でしたが、現代ではIoT※や車載向けなど、必ずしも最先端の技術を必要としない半導体デバイスの量的需要が増加したことで、先端ノードはもちろんのこと、レガシーノードにおいても市場規模の拡大が続いております。
半導体用フォトマスクの需要は、半導体デバイスメーカーにおける新たな技術ノードへの対応や、新たな生産プロセス構築のための「研究開発・試作生産フェーズ」と既に確立した生産プロセスを用いる「量産フェーズ」のそれぞれにおいて発生します。
そのため、半導体デバイスそのものの量的需要とは別に、半導体デバイスメーカーの技術開発・製品開発が続く限り、一定の需要が継続安定的に発生いたします。また、研究開発段階において半導体用フォトマスクを提供するパートナーに選ばれることにより、当社グループのフォトマスクが顧客の生産プロセスにおける基準として採用されるため、以後の量産段階における半導体用フォトマスク需要において、当社に最適化された製造仕様が適用されることで、セカンドベンダーとして他社が参入を図る際の技術的な参入障壁となります。そのため、当社グループでは自社における研究開発や顧客等との共同開発等に対して積極的な人的投資・設備投資を実行し、顧客の上流段階からの技術要求に精確かつ柔軟に対応できる技術・開発体制、並びに生産体制を構築しております。
半導体用フォトマスクの構造
半導体デバイスは、同一のシリコンウェハ上にフォトリソグラフィ工程を複数回繰り返し、回路パターンを多層(レイヤー)構造で成形することで生産されます。したがって、一つの半導体デバイスに対しフォトリソグラフィの回数分だけ複数枚のフォトマスクが必要となり、これらは一つのセットとして使用されます。
フォトマスクに要求される微細化の精度は各レイヤーにおいて異なり、一般に、微細化が進むと高精度なレイヤー(クリティカルレイヤー)において要求される加工精度がより微細なものとなるとともに、回路パターンの積層にあたっては低精度(ラフレイヤー)~中精度のレイヤー(ミドルレイヤー)も必要となるため、セットあたりのフォトマスク枚数も増加し、マスクセット単価が上昇する構造となっております。
また、ウェハ工程の歩留まり向上など、デバイスメーカーにおいてフォトマスクをセットで効率的に運用するには、フォトマスクの仕上がりの傾向やレイヤー間の重ね合わせ精度が重要となります。このことから、通常フォトマスクを外注する場合は同一のフォトマスクベンダーにセット単位で発注されます。

b 当社グループ製品
当社グループは顧客より支給される仕様に基づく完全受注生産のため、当社グループの独自の製品ラインナップと呼べるものは存在しません。他方、フォトマスクはその構造に基づき、以下のように大別することができ、当社グループでは顧客の要求仕様に合わせて各種フォトマスクの生産を受託しております。
c 当社グループの生産体制について
当社グループでは、アジア5工場、米国1工場、欧州2工場の計8工場でフォトマスクの製造を行っております(シンガポールのみ、2025年現在、フォトマスク製造工程において前工程にあたるデータ処理工程のみを行っておりますが、2026年に新工場が稼働予定です。)。外販フォトマスクの生産においては納期が非常に重要であり、顧客デバイスメーカーより回路パターンのデータを受領後、通常、最先端品でも2週間程度、レガシー品では2~3日程度と、極めて短い納期で納入することが要求されます。そのため、基本的に地産地消によって顧客の近くに工場を構え生産することが最良とされております。他方で、半導体需要はその時々、地域や顧客の事情により変動が大きいため、ある工場において単一の顧客又は工場が立地する地域顧客のみをもって工場の稼働率を常に高く維持することは困難であり、現地の最大需要に合わせて設備投資をすることは事業上のリスクを高めると考えられます。同様に、安易に設備投資、キャパシティ拡張を行うことが難しいため、繁忙期には需要が現地の生産キャパシティを超過する事態も発生し得ます。
当社グループではアジア・北米・欧州全ての地域で現地供給できる体制を整えており、現地顧客に対し短納期で製品を提供することはもちろん、繁忙期において現地工場のみでは対応しきれない顧客需要について、グループ内部の生産委託によって他地域の工場から供給する柔軟な製造体制を構築しております。これにより複数工場間で生産需要・キャパシティを平準化し、グローバル全体での工場稼働率を高く維持することを可能としております。
当社グループの生産体制

d 当社グループの優位性
(a) 技術開発の優位性について
当社グループでは、材料ベンダーと共同で先端マスクブランクスの開発を行っております。これにより材料の組成に関与し深い知見を得ることで、先端フォトマスクの生産において、自社の加工プロセスを最適化することが可能となっております。フォトマスクブランクスの特性はウェハの生産プロセスにも影響を与えるため、顧客プロセスへの最適化も企図したブランクスを開発し、同材料の採用を顧客に提案することで、先端品フォトマスク需要をいち早く取り込むことにも寄与しております。過去の開発成果の一つとして、バイナリーマスクでありながら高い精度を実現するOMOG材は、当社での採用にとどまらず、共同開発者であるブランクスベンダーを通して販売され、広く業界内に普及しております。現在は次世代EUV技術であるHigh-NA※向けEUVフォトマスクブランクスの開発にも取り組んでおり、EUV領域においても当社の開発した技術が業界標準となることを目指しております。
材料開発は、同時に知的財産権による当社グループの優位性構築にも寄与しており、導入初期において販売制限によって他社の参入を排除することはもちろんのこと、普及期においてはロイヤリティ収入を得る形で当社の業績に寄与することになります。
生産技術においても、過去の技術開発ノウハウとそのデータ蓄積に加え、AIの活用により、精度・効率の高いプロセス条件を早期に確立し生産性や良品率の向上を図っております。当社グループのノウハウは当社グループの生産プロセス改善のみならず、顧客プロセスの生産性向上も視野に、特に、HAZE※と呼ばれる顧客の生産プロセスにおいて同じフォトマスクを繰り返し使用することで発生するフォトマスクの品質低下に対し、それを抑制する取り組みを強化しております。HAZEが発生した際は当該フォトマスクのHAZEを除去するメンテナンス作業が必要となるところ、HAZEの抑制は顧客生産ラインの稼働率の維持・向上に直結するため、そのような課題を抱える顧客からは一定の評価を得ているものと認識しております。
(b) 高度な生産キャパシティ管理について
当社グループではクリティカルレイヤーで必要となるクリティカルレイヤー向け先端生産設備のみならず、ラフレイヤー・ミドルレイヤーで必要となるフォトマスクのためのレガシー生産設備も多数保有しております。これにより先端半導体デバイスにおけるフォトマスクの需要に対し、クリティカル~ラフレイヤーまで、セット単位で対応することができることに加え、量的需要が旺盛なレガシー半導体向けにも対応することが可能であり、広範囲なテクノロジーノードの需要に対応することが可能となっております。
過去に普及したレガシーノード向け生産設備は、現在すでに市場から同じ機種を調達することが困難となっており、新たに調達する場合はオーバースペックとなる先端ノード向けの生産設備を購入せざるを得ません。当社グループではレガシーノード向けフォトマスク生産設備の延命・維持管理にも力を入れており、セルフメンテナンスのノウハウ構築や、EOL※を迎えたパーツの代替品開発まで幅広く取り組んでおります。これによってレガシー設備の更新投資を最小化し、競合他社、とりわけ参入障壁の低いレガシーノード領域において新興フォトマスクメーカーに対し大きなコストアドバンテージを得ることにつなげております。
(c) グローバル生産体制によるタイムリーかつ柔軟な製品供給について
当社グループでは複数の製造拠点が連携して生産を行っており、製造拠点間のバックアップによって短納期での製品供給とBCP(事業継続計画)を実現しております。
通常、フォトマスクの生産に用いる描画機や検査機といった主要設備は、フォトマスク生産の受注前に顧客の使用許諾(認定)が必要であり、仮に同型機種であっても、その性能において個々に異なる傾向を示すことがあるため、工場が異なれば別個に認定を要求されることも少なくありません。当社グループでは、各生産設備のパラメータに補正をかけプロセス条件を最適化することで、異なる工場の生産設備を使用しても同じ特性の仕上がりとなるよう、サイト間・設備間のデータマッチング技術の高度化に注力しており、その成果として、短期間で複数の生産工場について認定を取得することを可能としております。
複数拠点での生産認定に加え、AIを用いた生産管理システムを構築することで、過去の生産データから各設備の工程能力や出荷までの工数を試算し、納期及び設備稼働の最適化を実現すべく、同生産管理システムの開発と改善に取り組んでおります。フォトマスクは顧客の半導体デバイスの設計に合わせた一点一様の製品であり、製品の仕様とその時々の各生産設備の稼働状況に合わせて、多岐に渡る使用すべき装置の組み合わせから、最適な工程順を検討する必要があります。特に、検査工程で欠陥が見つかった場合は修正工程と検査工程を複数回繰り返す可能性があるため、出荷納期のコントロールは容易ではありません。本生産管理システムを用いることで、納期予測の精度向上と、迅速かつ正確な顧客への納期回答を可能とし、得意先からの信頼向上や出荷枚数の増加を目指しております。
(d) 最先端領域での取り組みについて
当社グループでは、最先端領域において様々なパートナーとの共同開発プロジェクトに取り組んでおります。フォトマスクの材料ベンダー、生産設備ベンダーのみならず、Interuniversity Microelectronics Centre(imec)などの研究開発機関を介してウェハ工程も含めた様々な先端技術開発プレイヤーとの協働を展開しており、特に直近ではInternational Business Machines Corporation(IBM)社と2nm半導体向けEUVフォトマスクのプロセス共同開発契約を締結しております。
また、当社内部の取り組みとしてもマルチビーム描画装置※を用いたEUVフォトマスク生産の技術深耕に加え、半導体製造工程のウェハプロセスにおける光の性質を考慮して、フォトマスク上の回路パターンの最適化を図るCurvilinear※技術の開発にも注力しており、EUVのみならず従来型の光リソグラフィにおける更なる技術進展にも対応すべく、技術開発・研究開発の取り組みを進めております。
(新事業領域)
当社グループは、半導体用フォトマスク事業を通じて培ったリソグラフィ技術を応用し、高精度なナノインプリント用モールド及びシリコンステンシルマスクを開発、製造しております。
a ナノインプリント用モールド
ナノインプリントとは、樹脂をモールドと呼ばれる型と基板で挟み込み硬化させることで、数十ナノメートル単位のパターンを転写する微細加工技術です。工程がシンプルなため、微細構造体を安価に再現性良く大量に製造する技術として期待されております。当社グループは、半導体用フォトマスク事業を通じて培ったリソグラフィ技術を応用し、高精度なナノインプリント用モールドを開発、製造しております。
b シリコンステンシルマスク
シリコンステンシルマスクは、パターンを形成するためにナノスケールの貫通開口を加工した電子ビームリソグラフィ(EBリソグラフィ:Electron Beam Lithography)用のフォトマスクです。EBリソグラフィは、先端のマスクを作製するための技術として、半導体業界で研究が進められております。当社グループは微細加工技術をコア技術としてステンシルマスクの開発を進め、供給体制を構築しております。
(※用語)
(事業系統図)
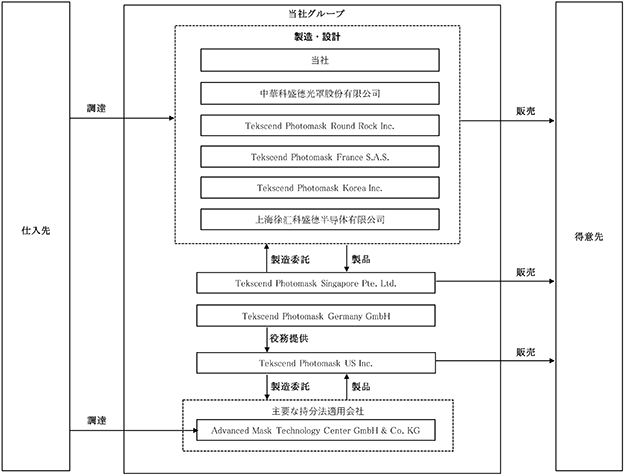
4 【関係会社の状況】
(注) 1.「主要な事業の内容欄」には、セグメント情報に記載された名称を記載しております。
2.特定子会社であります。
3.TOPPANホールディングス株式会社以外に有価証券届出書又は有価証券報告書を提出している会社はありません。
4.「議決権の所有(又は被所有)割合」欄の( )内は間接所有割合で内数です。
5.Tekscend Photomask GmbHは休眠会社です。
6.Tekscend Photomask US Inc.、Tekscend Photomask Round Rock Inc.、Tekscend Photomask Korea Inc.、中華科盛德光罩股份有限公司及び上海徐匯科盛徳半導体有限公司については、売上収益(連結会社相互間の内部売上収益を除く。)の連結売上収益に占める割合が10%を超えております。主要な損益情報等は以下のとおりです。なお、Tekscend Photomask US Inc.、Tekscend Photomask Round Rock Inc.、Tekscend Photomask Korea Inc.及び上海徐匯科盛徳半導体有限公司における主要な損益情報等については、米国会計基準に基づいております。
7.持分法適用関連会社の2社に関しては、GlobalFoundriesが50%の持分を保有しております。
5 【従業員の状況】
(1) 連結会社の状況
(注) 1.従業員数は、出向社員を除き、受入出向社員を含む就業人員数であります。
2.従業員数の[外書]は、臨時従業員の年間平均雇用人員数であります。
3.臨時従業員は、契約社員、パートタイマー及びアルバイトであります。
4.当社グループの報告セグメントはフォトマスク事業の単一セグメントであるため、セグメント別の従業員数の記載はしておりません。
(2) 提出会社の状況
(注) 1.従業員数は、出向社員を除き、受入出向社員を含む就業人員数であります。
2.従業員数の[外書]は、臨時従業員の年間平均雇用人員数であります。
3.平均年間給与は、賞与及び基準外賃金を含んでおります。
4.当社はフォトマスク事業の単一セグメントであるため、セグメント別の記載はしておりません。
(3) 労働組合の状況
当社の労働組合は、テクセンドフォトマスク労働組合と称し、2025年8月31日現在の組合員数は398人であり、上部団体の全日本電機・電子・情報関連産業労働組合連合会(電機連合)に所属しております。なお、労使関係については円滑な関係にあり、特記すべき事項はありません。
(4) 管理職に占める女性労働者の割合、男性労働者の育児休業取得率及び労働者の男女の賃金の差異
① 提出会社
(注) 1.「女性の職業生活における活躍の推進に関する法律」(平成3年法律第64号)の規定に基づき算出したものであります。
2.「育児休業、介護休業等育児又は家族介護を行う労働者の福祉に関する法律」(平成3年法律第64号)の規定に基づき、「育児休業、介護休業等育児又は家族介護を行う労働者の福祉に関する法律施行規則」(平成3年労働省令第25号)第71条の6第1号における育児休業等の取得割合を算出したものであります。
② 連結子会社
連結子会社は、海外籍であり、また、「女性の職業生活における活躍の推進に関する法律」(平成27年法律第64号)又は「育児休業、介護休業等育児又は家族介護を行う労働者の福祉に関する法律」(平成3年法律第76号)の規定による公表義務の対象外となるため、記載を省略しております。